삼성전자는 업계 최고 사양인 고성능 반도체용 2.5D 패키징 솔루션 'H-큐브'(Hybrid-Substrate Cube)를 개발했다고 11일 밝혔다.
패키징은 회로가 새겨진 반도체 웨이퍼에 전자기기가 서로 신호를 주고받을 수 있는 형태로 반도체 칩을 포장하는 기술이다. 반도체 성능과 생산 효율성을 높일 수 있다.
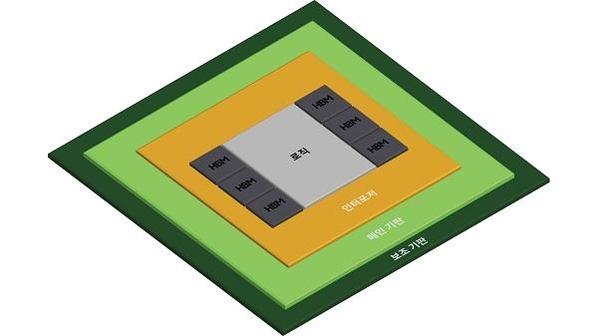
고성능 컴퓨팅(HPC)이나 데이터센터, 네트워크용 고사양 반도체에 적용될 전망이다.
삼성전자는 H-큐브가 기판 설계 최적화를 통해 HBM을 6개까지 탑재할 수 있도록 해 업계 최고 사양을 구현했다고 설명했다.
전 세대 패키징 기술인 'I-큐브4'는 로직 반도체에 메모리 HBM 4개가 들어갔다. 고성능 반도체 패키징 수요 증가에 따라 H-큐브는 기존보다 HBM 탑재량을 2개 더 늘렸다.
삼성전자는 이를 위해 메인 기판과 보조 기판을 전기적으로 연결하는 솔더볼(Solder ball)의 간격을 기존 대비 35% 좁혀 기판의 크기를 최소화하고, 다수의 HBM 탑재로 인해 증가하는 기판 제작의 어려움을 극복했다고 설명했다.
이번 H-큐브 패키징 솔루션 개발에는 삼성전자와 함께 반도체 후공정 전문 업체 앰코테크놀로지, 삼성전기도 협력했다.
강문수 삼성전자 파운드리사업부 마켓전략팀 전무는 "H-큐브는 고사양 반도체를 위한 최적의 솔루션이다"이라며 "앞으로도 파운드리 파트너와의 긴밀한 협력을 통해 기술적 한계를 넘어서는 다양한 패키징 솔루션을 제공해 나가겠다"고 말했다.
삼성전자 파운드리사업부는 8일 열린 '제47회 국가품질경영대회'에서 대통령표창 국가품질경영상을 수상했다. 삼성전자 반도체 부문이 대통령 표창 국가품질경영상을 받은 것은 이번이 처음이다.
삼성전자는 18일 파운드리 파트너사를 대상으로 '제3회 SAFE(Samsung Advanced Foundry Ecosystem) 포럼'을 온라인으로 개최해 고객들에게 파운드리 기술을 소개할 예정이다.
이광영 기자 gwang0e@chosunbiz.com

