반도체 미세공정이 10나노미터(㎚, 10억분의 1m) 이하대에 진입하면서 반도체 성능 간극을 메우는 데 도움이 되는 패키징 기술의 중요성이 커지는 추세다. 나아가 최근 반도체 업계는 보다 작고 빠르면서 전력소모가 적은 반도체 생산을 위해 칩을 3D로 적층하는 패키징 기법으로 전환하기에 이르렀다.
문제는 패키지 구조가 더 복잡해지면서 불량 가능성이 높아진다는 점이다. 복잡한 3D 구조 속에서 불량이 발생하는 물리적 위치를 정확하게 찾아내기도 쉽지 않다.
23일 서울 삼성동 코엑스에서 개막한 ‘세미콘코리아 2019’에 참가한 글로벌 공정제어솔루션 전문 업체 자이스(ZEISS)는 첨단 반도체 패키지의 불량 분석을 위한 새로운 고해상 3D 엑스레이 이미징 솔루션 3종을 선보였다.
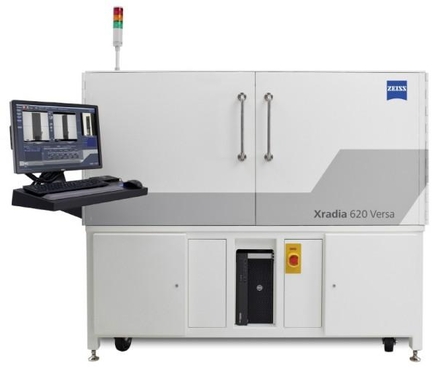
원리는 3D 컴퓨터단층촬영(CT)과 비슷하다. 샘플을 회전해 서로 다른 각도의 다양한 2D 엑스레이 이미지를 캡쳐한 다음 정교한 수학적 모델과 알고리즘을 사용해 3D 입체 모양을 재구성해 보여준다. 여러 각도에서 3D 입체의 가상 단면을 살펴볼 수 있어 물리적 불량 분석을 시도하기 전에 비파괴 방식으로 불량의 위치를 확인할 수 있게 된다는 게 회사 측 설명이다.
라즈 자미 자이스 공정제어솔루션 사장은 "이제 반도체 업계에서는 그 어느 때보다 패키지와 디바이스 특성이 3차원적으로 작아지고 있으며, 그에 따라 패키징 수율을 끌어올릴 수 있도록 불량을 신속하게 차단할 수 있는 새로운 이미징 솔루션이 필요해졌다"고 말했다.

